
-
 专利
专利 -
 商标
商标 -
 版权
版权 -
 商业秘密
商业秘密 -
 反不正当竞争
反不正当竞争 -
 植物新品种
植物新品种 -
 地理标志
地理标志 -
 集成电路布图设计
集成电路布图设计 -
 技术合同
技术合同 -
 传统文化
传统文化
点击展开全部
律师动态
更多 >>知产速递
更多 >>审判动态
更多 >>案例聚焦
更多 >>法官视点
更多 >>裁判文书
更多 >>
(国家知识产权局专利分析普及推广项目高端通用芯片课题组)
专利离你很远,专利其实离你很近。举个例子,未来如何让手机功耗更低功能更强,寄望于3D集成技术。中国的集成电路产业正在逐步进入3D芯片领域,其专利态势如何,本文为您细分析。
目前,世界各国都高度重视3D集成技术的研究,它已成为提高系统集成度和增强系统性能的关键技术。使用3D集成技术可以把不同类型的元器件堆叠在一起,不仅广泛应用于手机、大容量存储器等民用领域,还越来越多地受到RF组件、T/R模块、小型传感器等应用领域的青睐,必将在未来小型化、多功能微系统应用中大显身手,可以说,3D集成技术已经成为16/14nm工艺中的关键技术之一。3D芯片热管理技术是3D芯片领域的研发热点,技术更新比较快。从产业发展水平来看,中国的集成电路产业虽然正在逐步进入3D芯片领域,芯片制造能力持续增强,但在3D芯片热管理方面才刚刚起步,远远落后于国外水平。
基于行业发展需求,国家知识产权局专利分析普及推广项目高端通用芯片课题组从3D集成中国专利现状与趋势、3D集成关键技术TSV、3D集成热管理等三个视角出发,对高端通用芯片的3D集成技术进行了深度剖析。
一、3D集成中国专利现状与趋势
从专利年申请量方面来看,3D集成技术的中国相关专利申请总体呈现快速增长趋势。截至2015年5月31日,3D集成技术中国专利申请总申请量为1113件。
从1996年到2006年为缓慢发展期,一共有123件专利申请,大约占全部申请量的11%。从2007年到2011年为快速发展期,一共有516件专利申请,大约占全部申请量的46%,在这一阶段3D集成技术高速发展,并且在2011年达到顶峰,一年申请量达到191件。而从2012年至今为整固发展期,一共有474件专利申请,大约占全部申请量的43%,2012年申请量较2011年有所回落,虽然在一定程度上受到专利申请的公开滞后的影响,但2013-2015年,3D集成技术的专利申请量仍然处于高位状态,表明3D集成技术的研发活动仍然处于活跃期。同时也从另一个角度表明中国是3D集成技术目前和未来一段时间内的重要生产和应用市场,具有巨大的市场潜力。虽然3D集成技术中国专利申请出现年代较晚,但是中国专利申请趋势与全球专利申请趋势比较类似,专利申请量增长也较为迅速,尤其是近几年来呈现出陡坡式增长,逐渐缩小了与全球专利申请的差距。
二、3D集成关键技术——TSV
3D集成TSV领域中国总申请量为547件,大约是3D集成技术中国全部专利申请量的一半,而且根据目前3D集成技术的发展来看TSV是3D集成的关键技术。
根据目前掌握的现有专利数据的初步分析,以及对3D集成技术本身并结合3D集成的产业特点来看,3D集成技术的发展可以考虑基于现有TSV结构进行新结构的研究开发,以3D集成TSV技术的填充工艺为突破口,加强对填充新材料和新应用相结合的研发力度,例如在TSV中填充碳纳米管、光纤等材料,另外,也可以结合对TSV填充材料而关注TSV的新应用,抢先进行专利布局,形成一定的技术优势,来带动3D集成TSV技术工艺研发的全面发展。
三、3D集成热管理
全球的研发方向主要在于热交换器和TSV。由于这两个研发方向是热管理方面的主流技术,因此国内企业应在这两方面加强研发工作。同时,热量分步计算分析技术和芯片间热失配缓解装置以及在3D芯片中增加热传感器是近年来较新出现的技术,具有比较大的发展潜力,而国外申请人基本上还没有就这些方面的技术在国内进行专利布局,因此国内研发主体可以在这些方向上加强研发以争取领先地位。
专利离你很远,专利其实离你很近。举个例子,未来如何让手机功耗更低功能更强,寄望于3D集成技术。中国的集成电路产业正在逐步进入3D芯片领域,其专利态势如何,本文为您细分析。
目前,世界各国都高度重视3D集成技术的研究,它已成为提高系统集成度和增强系统性能的关键技术。使用3D集成技术可以把不同类型的元器件堆叠在一起,不仅广泛应用于手机、大容量存储器等民用领域,还越来越多地受到RF组件、T/R模块、小型传感器等应用领域的青睐,必将在未来小型化、多功能微系统应用中大显身手,可以说,3D集成技术已经成为16/14nm工艺中的关键技术之一。3D芯片热管理技术是3D芯片领域的研发热点,技术更新比较快。从产业发展水平来看,中国的集成电路产业虽然正在逐步进入3D芯片领域,芯片制造能力持续增强,但在3D芯片热管理方面才刚刚起步,远远落后于国外水平。
基于行业发展需求,国家知识产权局专利分析普及推广项目高端通用芯片课题组从3D集成中国专利现状与趋势、3D集成关键技术TSV、3D集成热管理等三个视角出发,对高端通用芯片的3D集成技术进行了深度剖析。
一、3D集成中国专利现状与趋势
从专利年申请量方面来看,3D集成技术的中国相关专利申请总体呈现快速增长趋势。截至2015年5月31日,3D集成技术中国专利申请总申请量为1113件。

从1996年到2006年为缓慢发展期,一共有123件专利申请,大约占全部申请量的11%。从2007年到2011年为快速发展期,一共有516件专利申请,大约占全部申请量的46%,在这一阶段3D集成技术高速发展,并且在2011年达到顶峰,一年申请量达到191件。而从2012年至今为整固发展期,一共有474件专利申请,大约占全部申请量的43%,2012年申请量较2011年有所回落,虽然在一定程度上受到专利申请的公开滞后的影响,但2013-2015年,3D集成技术的专利申请量仍然处于高位状态,表明3D集成技术的研发活动仍然处于活跃期。同时也从另一个角度表明中国是3D集成技术目前和未来一段时间内的重要生产和应用市场,具有巨大的市场潜力。虽然3D集成技术中国专利申请出现年代较晚,但是中国专利申请趋势与全球专利申请趋势比较类似,专利申请量增长也较为迅速,尤其是近几年来呈现出陡坡式增长,逐渐缩小了与全球专利申请的差距。
二、3D集成关键技术——TSV
3D集成TSV领域中国总申请量为547件,大约是3D集成技术中国全部专利申请量的一半,而且根据目前3D集成技术的发展来看TSV是3D集成的关键技术。

根据目前掌握的现有专利数据的初步分析,以及对3D集成技术本身并结合3D集成的产业特点来看,3D集成技术的发展可以考虑基于现有TSV结构进行新结构的研究开发,以3D集成TSV技术的填充工艺为突破口,加强对填充新材料和新应用相结合的研发力度,例如在TSV中填充碳纳米管、光纤等材料,另外,也可以结合对TSV填充材料而关注TSV的新应用,抢先进行专利布局,形成一定的技术优势,来带动3D集成TSV技术工艺研发的全面发展。
三、3D集成热管理

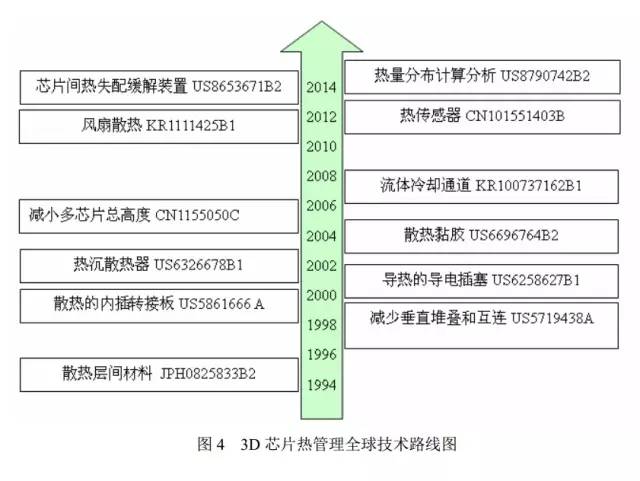
全球的研发方向主要在于热交换器和TSV。由于这两个研发方向是热管理方面的主流技术,因此国内企业应在这两方面加强研发工作。同时,热量分步计算分析技术和芯片间热失配缓解装置以及在3D芯片中增加热传感器是近年来较新出现的技术,具有比较大的发展潜力,而国外申请人基本上还没有就这些方面的技术在国内进行专利布局,因此国内研发主体可以在这些方向上加强研发以争取领先地位。






 首页
首页 上一篇
上一篇 





评论